Welcome to visit our website.

202231 · Abstract Three-dimensional integration using through-silicon via (TSV) can significantly improve the performance and power consumption of microelectronic devices. In order to connect more chips vertically using TSV, the silicon wafer should be as thin as possible. As the most widely used method for wafer thinning, constant-feed grinding …
view more
2021126 · We previously reported a method for the extraction of nucleic acids without mechanical tissue grinding using a buffer containing potassium ethyl xanthogenate (PEX) to detect viroid RNAs.
view more
202461 · The material removal mechanism by which the magnetic field enhanced chemical mechanical polishing was revealed by comparing the surface morphology and reaction products with and without magnetic assistance. The method proposed in this study focuses on exploring the feasibility of this composite polishing process for quartz internal …
view more
20231228 · Honing and Superfinishing. Honing tool used to improve the surface finish of bored or ground holes. Schematic illustrations of the superfinishing process for a cylindrical part. (a) Cylindrical mircohoning, (b) Centerless microhoning.
view more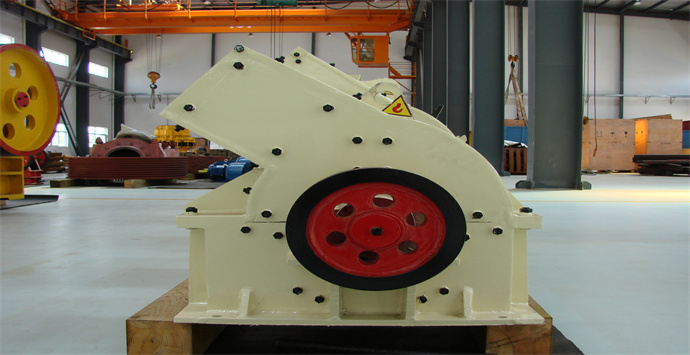
202291 · High-speed grinding technology is being applied to the precision machining of 20CrMnTi steel gears, shafts and bearings suffering from fatigue damage. The response surface methodology (RSM) was used as an optimization method of high-speed grinding parameters to reach a higher anti-fatigue performance of 20CrMnTi steel workpieces. The …
view more
2022101 · To fill this gap, this work reviews and introduces theoretical methods and applications of mechanics in grinding from the aspects of modeling principles, limitations and possible future ...
view more
201992 · Experiments are conducted to verify the reasonability of the improved chip-thickness model from the perspective of surface roughness, and the findings are likely to clarify the differences in material removal mechanism between wheel grinding and robotic belt grinding essentially.
view more
Thinning Techniques. There are four primary methods for wafer thinning: mechanical grinding, chemical mechanical polishing (CMP), wet etching and atmospheric downstream plasma (ADP) dry chemical etching (DCE). Because of its high thinning rate, mechanical grinding currently is the most common technique for wafer thinning.
view more
2023929 · The force model, which plays a significant role for the application of grinding in various fields, is the most straight forward and comprehensive mathematical expression to describe the mechanical behavior of material removal. However, current research primarily focuses on modeling of grinding force in simple processes and …
view more
202431 · Highlights • Summary of grinding residual stress generation mechanism and its future research outlook. • Elaboration of grinding residual stress modelling and summary of material removal mechanisms. • Summary of research on the mechanism of change in microscopic material processing and its research significance. • Application of residual …
view more

Based on over 30 years' experiences in design, production and service of crushing and s
GET QUOTE